Материал - база
Cтраница 2
При повышении температуры изменяются физические константы материала базы, а также резко возрастают токи насыщения переходов Is ( темповой ток фотодиода), / эо и / ко, что приводит к изменению режима по постоянному току особенно у фототранзистора, включенного по схеме с разомкнутой базой. Так, темновой ток фотодиода возрастает с 5 - 10 мка при 20 С до 100 - 150 мка при 70 С, а темновой ток фототранзисторов с 50 - 100 мка при 20 С до 1 000 - 1 700 мка при 70 С. [16]
Емкость эмиттерного перехода совместно с распределенным сопротивлением материала базы rg является основной причиной частотной зависимости токов транзистора. Кроме того, на сопротивлении гб бесполезно тратится часть подводимого к базе внешнего напряжения UQ, в результате чего напряжение на эмиттерном переходе оказывается ослабленным. [17]
Омическое сопротивление базы зависит от удельного сопротивления материала базы и ее конфигурации. На рис. 5.5 приводятся формулы для расчета гб1 при различной встречающейся на практике геометрии плоскостных транзисторов. [18]
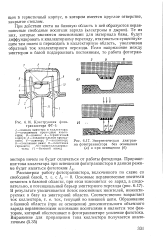 |
Конструкция фототранзистора ФТ-1.| Энергетическая диаграмма фототранзистора без освещения ( а и при освещении ( б. [19] |
Те из них, которые являются неосновными для материала базы, будут диффундировать к коллекторному переходу, втягиваться существующим там полем и переходить в коллекторную область, увеличивая обратный ток коллекторного перехода. [20]
 |
Конфигурации переходов мощных сплавных транзисторов. [21] |
До некоторой степени это явление можно устранить, применяя материал базы с большой диффузионной длиной и повышая эффективность эмиттера. Но изготовление таких транзисторов ограничено тем, что при технологии вплавле-ния затруднено выполнение достаточно большого числа переходов в виде узких полос. [22]
Величина сопротивления базы rg определяется конструкцией транзистора и удельным сопротивлением материала базы. [23]
Оно зависит от тока эмиттера постольку, поскольку удельное сопротивление материала базы изменяется при инжекции неосновных носителей. [24]
 |
Расширение области объемного заряда изолирующего р-п перехода ИС.| Транзистор полупроводниковой ИС со скрытым слоем. [25] |
Ток базы вызывает появление продольной составляющей падения напряжения в объеме материала базы, направленной от центральной части эмиттерного перехода к выводу базы. Наибольшим сопротивлением обладает тонкий слой базовой области, расположенный между эмиттерным и коллекторным переходами. [26]
Этот параметр определяется, как и в диоде, удельным сопротивлением материала базы и ее размерами. Однако в транзисторе существенное влияние на сопротивление базы оказывает напряжение на коллекторе. [27]
Напряжение ы3б отличается от напряжения иэ на величину падения напряжения на материале базы и эмиттера. [28]
 |
Устройство сплавного транзистора.| Условные обозначения транзистора р-п - р-типа и п-р-п-типа. [29] |
Транзисторы п - р - - типа имеют аналогичное устройство, только материал базы в них обладает дырочной проводимостью, а коллектор и эмиттер - электронной. [30]
Страницы: 1 2 3 4 5