Прямое смещение
Cтраница 4
При очень высоких прямых смещениях, больших чем КДИф, могут возникать два предельных случая. В одном из этих случаев переход достаточно узок для того, чтобы рекомбинация была относительно небольшой, и, следовательно, инжектированные концентрации носителей заряда будут везде преобладающими. [46]
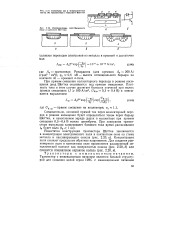 |
Структура ( а и эквивалентная схема ( tf транзистора с барьером Шоттки. [47] |
При прямом смещении коллекторного перехода в режиме насыщения диод Шоттки оказывается под прямым смещением. [48]
При прямом смещении эмиттерного перехода снижается его потенциальный барьер и происходит инжекция электронов из эмиттера в базу. Инжектированные электроны проходят базу и, дойдя до коллекторного перехода, экстрагируются ( втягиваются электрическим полем) в коллектор. [49]
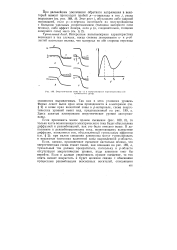 |
Энергетические зоны ( а-г и вольтамперная характеристика ( 3 туннельного диода. [50] |
Если приложить малое прямое смещение ( рис. 189, б), то только часть возникающего электрического тока будет обусловлена диффузией и рекомбинацией, как это было описано выше. В дополнение к рекомбинационному току, возникающему вследствие диффузии, появляется ток, обусловленный туннельным эффектом ( см. § 2): при малом смещении электроны могут туннелировать в незанятые состояния валентной зоны вырожденной р-области. [51]
В случае прямого смещения, очевидно, целесообразно выбирать такую величину тока, при которой сопротивление р-п перехода становится малым по сравнению с сопротивлением базы. [52]
В случае прямого смещения потенциал V положителен, избыточные неосновные носители заряда, инжектированные через р - n - переход, точно нейтрализуются всюду соответствующим зарядом основных носителей, поступающих через задний контакт. [53]
В случае прямого смещения потенциал V положителен, избыточные неосновные носители заряда, инжектированные через р - - переход, точно нейтрализуются всюду соответствующим зарядом основных носителей, поступающих через задний контакт. [54]
 |
Схема включения транзистора при коротком замыкании эмиттер - база и положительном смещении на коллекторе. [55] |
В случае прямого смещения ток, измеряемый прибором, практически не изменяется. Это объясняется тем, что величина шунтирующего сопротивления сравнима с сопротивлением коллекторного перехода при отрицательном смещении, но во много раз больше сопротивления коллекторного перехода при прямом смещении. [56]
В случае прямого смещения полупроводник становится отрицательно заряженным относительно металла. [57]
В случае прямого смещения потенциал V положителен, а в случае обратного смещения отрицателен. Поэтому при увеличении обратного напряжения смещения ( V отрицательно) ехр ( - eV / kT) в выражении (4.8) стремится к нулю. [58]
В случае прямого смещения ток определяется рекомбинацией носителей в области пространственного заряда. [59]
При приложении прямого смещения потенциальный барьер в р-п переходе понижается и диффузионный ток возрастает. Диффузионный ток состоит из основных носителей заряда, проникающих в область полупроводника, для которой они являются неосновными носителями. Концентрация неосновных носителей при этом может существенно возрасти по сравнению с их равновесной концентрацией, которая определяется скоростью тепловой генерации. [60]
Страницы: 1 2 3 4 5